真空集群系统(Vacuum Cluster System)
真空集群系统由配备真空机器人的传输模块和连接到 EFEM 的负载锁定室组成。 真空集群系统是一种通过连接到半导体制造工艺中使用的CVD、ALD、干式蚀刻机和溅射等半导体工艺设备的工艺模块来装载和卸载半导体晶圆的工具。
真空集束系统具有优异的真空性能、空间优化的结构、最小的安装空间、真空室中的颗粒抑制功能、高生产率等优点,并有多种型号,可以根据客户的要求提供各种应用。
传输模块有并行、径向和串联类型,负载锁定模块可配置以下特性和功能。 即,多层结构、可装载26片晶圆的批量式(分度器)、最小化抽气/排气时间的结构、通过预热/冷却功能减少水分、安装能够去除静电的光电离装置等
通过将传输模块和L/模块与各种型号和功能适当组合,可以配置最高的生产率和最佳的工艺设备。
| Twinstar Series | Maxima Series | Optima Series |
|
|

|

|
|
Twinstar 系列专为优化双晶圆工艺而设计,具有卓越的性能和高产量。 该系统最多可连接 3 个双处理模块。 |
Maxima 系列经过优化,具有卓越的性能和高吞吐量。该系统最多可连接 6 个工艺模块。 | Optima 系列经过优化,具有卓越的性能和高吞吐量。该系统可连接至更长处理时间的模块 |
TWINSTAR Series
TWINSTAR 系列专为双晶圆加工而设计,经过优化,可实现卓越的性能和高晶圆产量。 最多可配置三个双处理模块。

特征
专门设计的带 AWC 的 7 轴真空机器人实现高吞吐量和可靠性
复式设计和高通量负载锁定室
晶圆预热装置(选配)
适用于 CVD、干法蚀刻和 ALD 工艺
SEMI/MESC的兼容性
CE 标志和 SEMl S2 的满意度
规格
晶圆放置重复性:≤±0.1 mm
基础压力:10-3 Torr(适用于 10-7Torr)
颗粒:≤ 5 ea @40nm
MCBF:>100,000 次循环
UPEH:307 片晶圆/小时
|
专用装载锁/Specialized LoadLock 双层Load Lock可以最大限度地提高晶圆处理能力。
|
特征
堆叠式 LL 室
小室容积 - 高 吞吐量 带无颗粒 L 运动的狭缝阀
规格
室:Al 5083 顶盖:Al 508310 插槽:8插槽(上4插槽,下4插槽)/陶瓷/10mm间距 门阀:L-Motion/AL6061Viton O 形圈 |
|
预热/冷却板(选配) 负载锁定腔室增加预热/冷却功能可显着提高晶圆产量
散热模块 PCW流通 带陶瓷球的冷却板 气缸上/下运动 维护方便 |
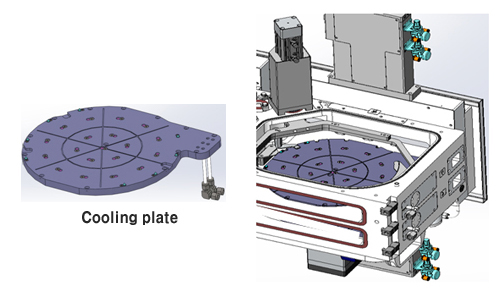
|
|
Wafer Pre-heating in LL
最高温度 300°C 加热卡盘模块 固定向上/向下运动
|
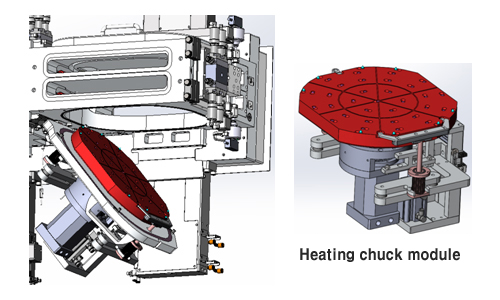
|
|
光电离子除静电(选配)
当晶圆停留在装载锁中时,通过软X射线电离的N2气体喷射到晶圆表面,以去除晶圆上的静电,从而防止颗粒粘附到晶圆表面 |
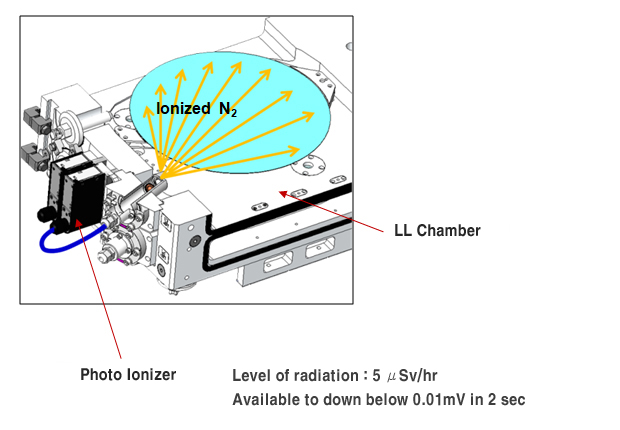
|
MAXIMA Series
MAXlMA 系列专为卓越性能和高吞吐量而设计,并提供各种专业选项。 最多可配置6个工艺模块,可大幅提高生产率,特别是对于需要高真空或高温工艺的工艺设备

特征
提供多达 8 面的传输室
2 个开槽 LL 或 25 片批量 LL
可在 LL 室中进行预热和后冷却(可选)
经过现场验证的具有 AWC 功能的真空机器人
规格
晶圆放置重复性:≤ ± 0.1 mm 底压:10-3Torr(可用于 10-8Torr)
颗粒:≤ 5 ea @40nm
UPEH:148 片晶圆/小时
兼容 SEMI/MESC
满足 CE 标志和 SEMl S2
Maxima-UHV
Maxima UHV 真空集束系统专为低氧低湿、低排气、高真空等特殊环境要求的工艺模块而设计。 它还可以配置为串联连接八角形传输模块。
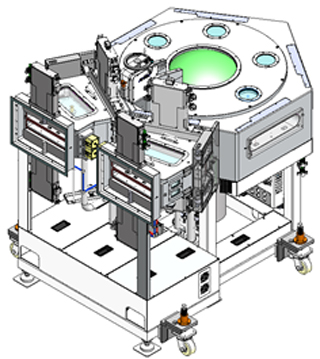
|
特征
规格
|
Maxima -HT
它专为选择性外延生长和高温外延工艺而设计,可与高达 850'C 的工艺室兼容。 由于外延工艺的特点,为了保持半导体衬底表面处于超洁净状态,对铝室进行了特殊的表面处理,对不锈钢盖进行了电镀处理,以最大限度地减少水分和排气。

|
特征
规格
|
专用装载锁
双层Load Lock可以最大限度地提高晶圆处理能力。
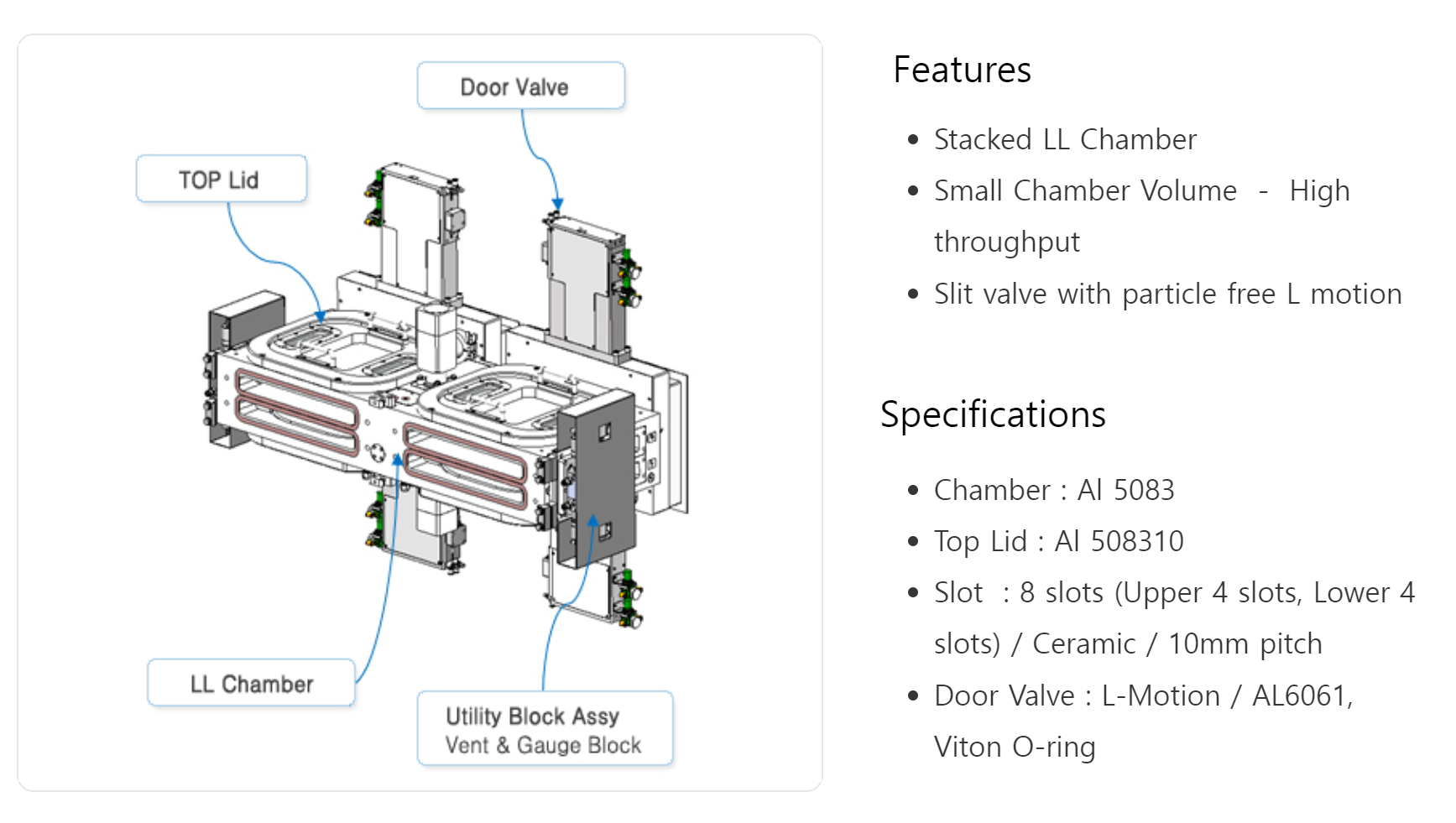



OPTIMA Series
OPTlMA 系列经过优化,具有卓越的性能和高晶圆吞吐量。 特别适合配置需要较长处理时间的处理模块,例如 ALD。
|
特征
规格
|

|
OPTIMA 3200
Optima3200 专为高吞吐量和小占地面积而设计,以提高半导体工厂的生产力。
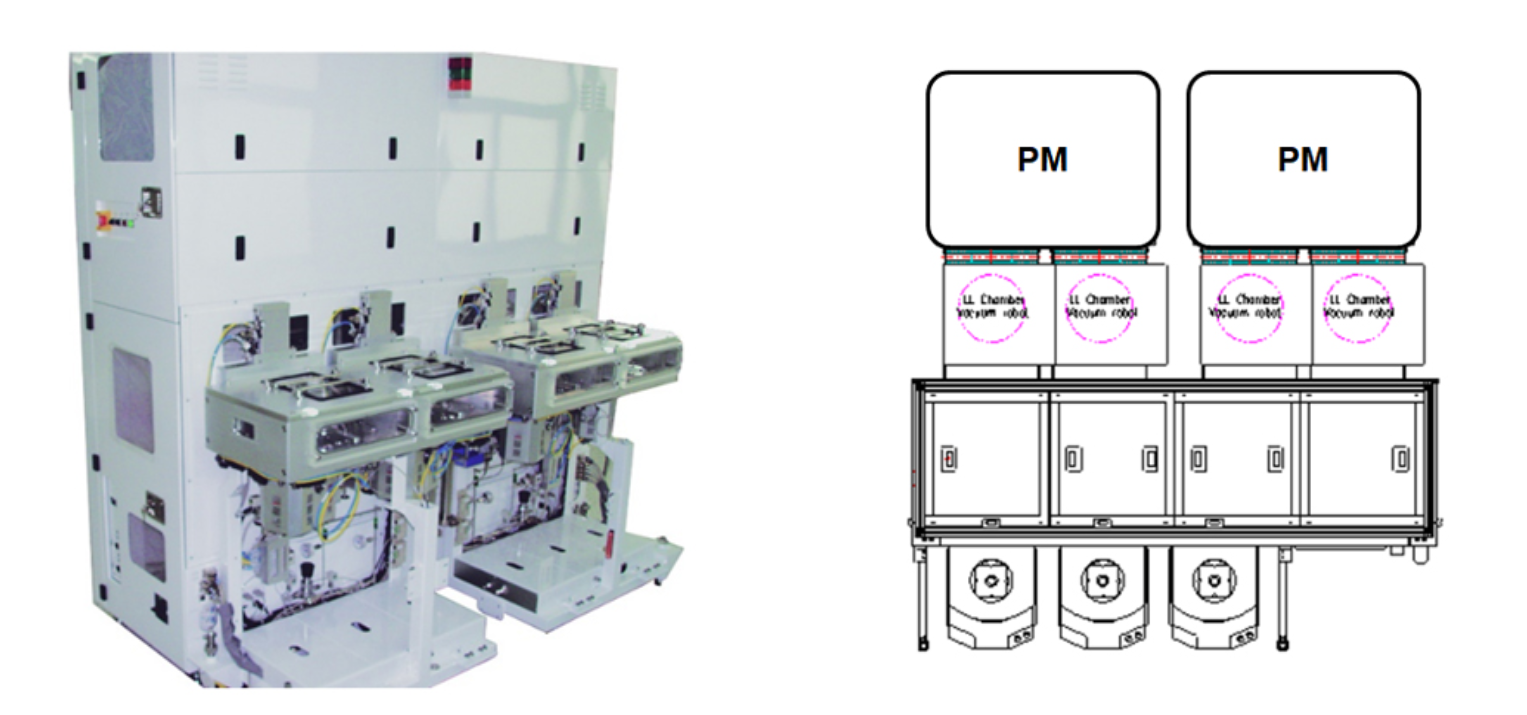
|
特点与优势
|


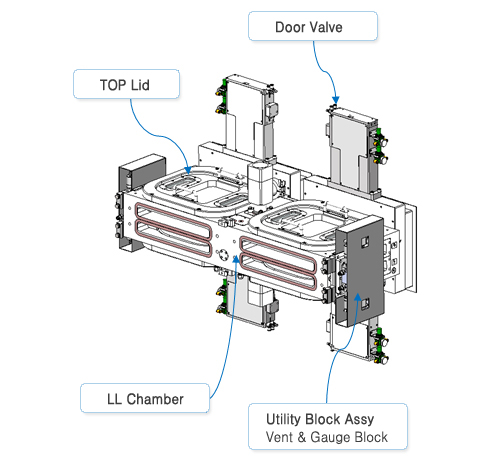

 售前咨询专员
售前咨询专员
