晶圆临时键合系统(Temporary Wafer Bonding System)
在扇出晶圆(面板)级封装中,芯片以晶圆/面板的形式重新排列,用于小型化芯片的RDL和凸点等布线工艺,并将载体晶圆(玻璃)临时粘合到背面以扩散翘曲成型过程中产生的,这是一个执行此操作的系统。此外,在半导体堆叠的TSV工艺中,它是一种将器件晶圆背面研磨至超薄形状,并通过用粘合剂涂覆或层压将载体晶圆暂时粘合到器件晶圆正面的系统,用于诸如RDL 和背部碰撞。
如果使用的临时胶是Glue,则先旋涂然后预固化,然后在真空室内通过高精度对位和热压进行临时粘合,确保上下晶圆吻合。薄膜,技术是贴合后将薄膜暂时粘合适用。
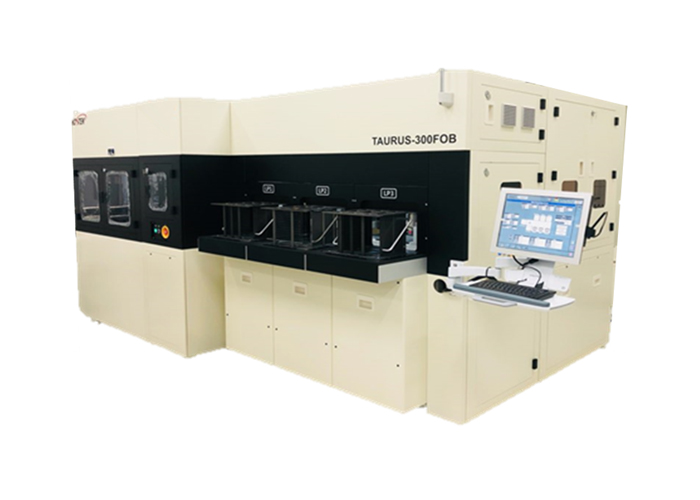
特征
1、使用薄膜/胶水粘合剂临时粘合载体晶圆,用于背面研磨、光刻胶、蚀刻、沉积、电镀、RDL、凸块工艺;
2、真空中的光学或机械对准;
3、真空中的光学或机械对准;
4、优异的压制均匀性;
5、通过均匀按压避免晶圆损坏;
规格
1、贴合后翘曲度:≤500um;
2、粘合温度 均匀度:最大300℃,≤±2%;
3、晶圆对位精度:≤±50μm;
4、Void : Free;
5、TTV:≤3um;
6、UPEH(取决于材料特性):≥30片/小时;
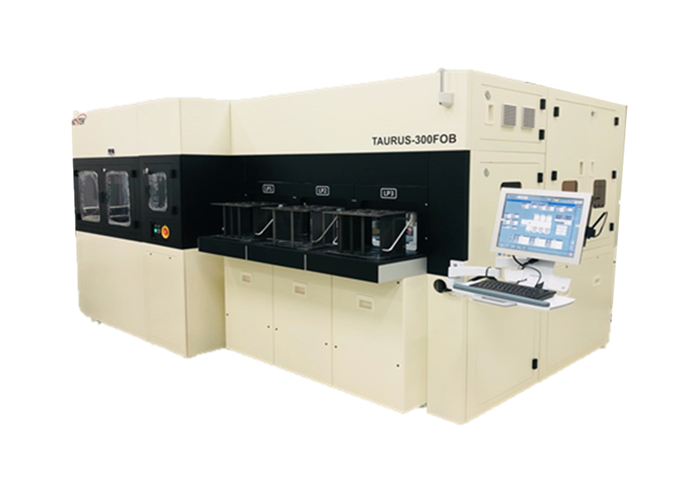
 售前咨询专员
售前咨询专员
