Micro LED显示设备(Micro LED Display Equipment)
芯片转移系统(Wafer Bonder)
该设备用于Micro LED制造过程中的第一道转移工序,以一次性去除Micro LED芯片。 第一步工艺包括在玻璃承载基板上形成粘合剂层,将Micro LED蓝宝石基板附着在涂覆有粘合剂层的玻璃承载基板上,并通过激光(LLO)工艺分离蓝宝石基板。
用于批量生产的系统,由一台旋涂机、一台热板和3个邦定模块组成,设备可根据工艺特点和产能进行配置。

|
|
|
特征
规格
|
|
对准器和预粘合器(Aligner & Pre-bonder)
该系统将上面转移有微型 LEDRed、Green 和 Red 芯片的矩形载体玻璃基板临时粘合到 TFT/CMOS 驱动板上,以实现彼此之间的电互连。
使用ACF、凸块作为电连接介质,也可以使用各电极之间不使用凸块或导电球的直接接合。

|
特征
规格
|
热共晶键合机(Thermal Eutectic Bonder)
热共晶键合机是热压键合机的一种,通过对上下加热盘的加热和加压,将上下集合芯片的电极键合到载体基板上。
在这种情况下,可以在每个电极之间使用凸块或ACF膜。 近年来,随着Micro LED芯片的尺寸变得越来越小,需要无需Micro Bump或ACF而将电极与电极直接连接的接合技术。 因此上下卡盘的平行度/压力均匀性/性能变得更加重要。低熔点键合采用铜合金、SnAg、AuSn等材料制成的电极和凸块。
在Micro LED显示器的三步转移制程中,第一步和第二步是通过Aliqner & Pre.bonder设备进行的,最后的Post Bonding是通过该设备完成的。作为Micro LED TV的制造设备,它是一种设备 能够粘合6英寸至12.7英寸尺寸的板。

|
特征
规格
|
激光共晶接合机(Laser Eutectic Bonder)
在Micro LED的Front Plane的电极(Pad)与Back Plane的电极(Pad或Micro Bump)相互对准后临时粘合的状态下,该系统可以通过低温下可用的激光加热方法将它们粘合。
作为Micro LED TV的制造设备,它是能够粘合6英寸至12.7英寸尺寸板的设备。
铜合金、SnAg、AuSn、Au、Ag等用于低熔点接合的焊盘或微凸块材料。

|
特征
规格
|
AR/VR激光共晶接合机(AR/VR Laser Eutectic Bonder)
在我们为 AR、VR、XR、智能手表制造 Micro LED 显示器的系统中,我们有激光
共晶接合机。该设备将 LED 外延片上 0.3~0.7 英寸的 Micro LED 模切件与对齐的 CMO 驱动板接合在一起。
为了克服蓝宝石和硅之间由于热膨胀系数不同而造成的对准偏差,采用激光加热仅加热凸块或电极区域进行焊接,而不是热压接合方法铜合金、SnAg、AuSn 、Au、Ag等用于低熔点接合的焊盘或微凸块材料。
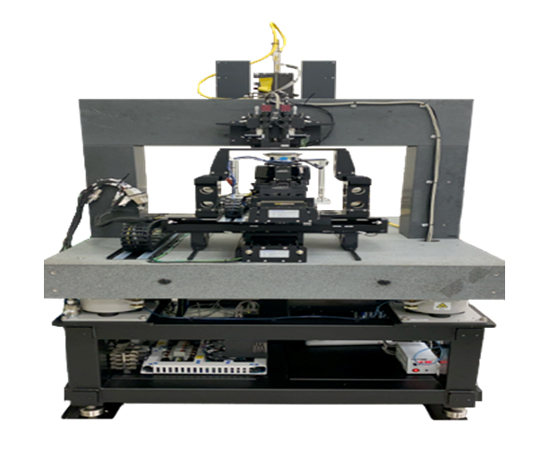
|
特征
规格
|

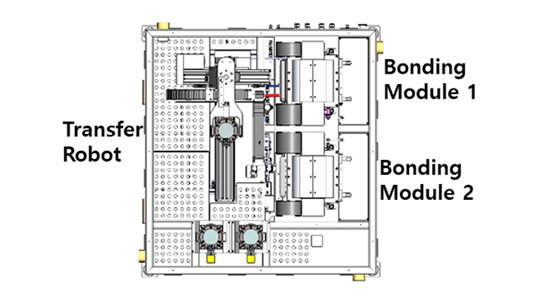

 售前咨询专员
售前咨询专员
